檢測中聚焦離子束(FIB)的綜合應用
聚焦離子束(focused ion beam,F(xiàn)IB)技術應用于不同領域中的微納結構制造中,利用電透鏡將離子束聚焦成非常小尺寸的離子束轟擊材料表面,實現(xiàn)材料的剝離、沉積、注入、切割和改性,成為微納加工技術中不可替代的重要技術之一,目前已廣泛應用于半導體集成電路修改、離子注入、切割和故障分析等。今天,就來簡單說幾種檢測中聚焦離子束(FIB)的綜合應用。
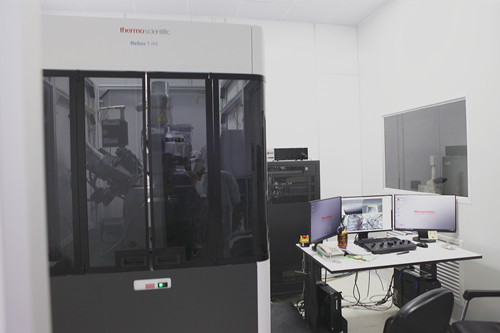
一、FIB可應用于透射電鏡的制樣
透射電鏡的樣品制備在研究中有十分重要的作用,TEM制樣需制備十分薄的樣品,便于電子穿透樣品,形成電子衍射的圖像。樣品的厚度需要在100nm一下,通過以往手工研磨和離子濺射減薄,費時費力,成功率不高,而塊狀材料的制備,更加難以對樣品進行精準的定位。聚焦離子束技術成功地解決了透射電鏡精確定位樣品的制備問題。FIB可以在需要的區(qū)域定點沉積保護層處理后,利用聚焦離子束從切片區(qū)域的前后兩個方向加工、挖坑,然后利用納米機械手將樣品轉移到銅網(wǎng)上進行最終減薄形成小于100nm厚度的薄片作為TEM觀察樣品。
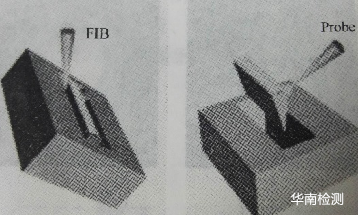
圖2.1 用FIB制備的TEM樣品
(2)截面切割表征分析
利用FIB的濺射刻蝕功能可以對樣品進行定點切割,觀察其橫截面(cross-section)表征截面形貌尺寸,同時可以配備結合元素分析(EDS)系統(tǒng)等,對截面成分進行分析。一般用于芯片、LED等失效分析領域,一般IC芯片加工過程中出現(xiàn)問題,通過FIB可以快速定點的進行分析缺陷原因,改善工藝流程,F(xiàn)IB系統(tǒng)已經(jīng)成為現(xiàn)代集成電路工藝線上不可缺少的設備。
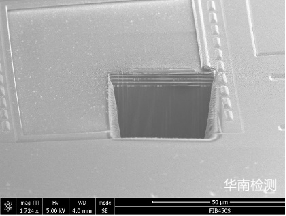
圖2.2 FIB對樣品缺陷區(qū)域進行截面切割分析
(3)芯片修補與線路編輯
在IC設計中,需要對成型的集成電路的設計更改進行驗證、優(yōu)化和調(diào)試。當發(fā)現(xiàn)問題后,需要將這些缺陷部位進行修復。目前的集成電路制程不斷縮小。線路層數(shù)也在不斷增加。運用FIB的濺射功能,可將某一處的連線斷開,或利用其沉積功能,可將某處原來不相連的部分連接起來,從而改變電路連線走向,可查找、診斷電路的錯誤,且可直接在芯片上修正這些錯誤,降低研發(fā)成本,加速研發(fā)進程,因為其省去了原形制備和掩模變更的時間和費用。

如今FIB技術發(fā)展已經(jīng)今非昔比,進步飛快,F(xiàn)IB不斷與各種探測器、微納操縱儀及測試裝置集成,并在今天發(fā)展成為一個集微區(qū)成像、加工、分析、操縱于一體的功能極其強大的綜合型加工與表征設備,廣泛的進入半導體行業(yè)、微納尺度科研、生命健康、地球科學等領域。華南檢測技術專注工業(yè)CT 檢測、失效分析、材料分析檢測、芯片鑒定、芯片線路修改、晶圓微結構分析、可靠性檢測、逆向工程、微納米測量等專業(yè)技術測服務,歡迎前來咨詢了解,客服咨詢熱線:13926867016。
熱門資訊 
最新資訊 
- ?PCBA失效分析實驗室:如何用高端檢測設備,精準診斷“不明原因”批量故障
- PCB失效分析檢測機構 - 廣東省華南檢測CNAS實驗室
- 芯片焊點失效分析“破案”實錄:一文看懂如何根治焊接隱患
- 元器件失效分析全解讀:定位根因,終結批量性質量危機
- 電子元器件失效分析案例深度解讀:MOS管柵氧擊穿的原因與預防
- 元器件篩選權威解讀:為何第三方檢測是保障產(chǎn)品可靠性關鍵一環(huán)?
- 塑膠失效分析:深度剖析塑膠螺絲柱開裂失效分析的全過程與解決方案
- 塑料失效分析:外殼開裂的根本原因診斷與案例深度解析 | 華南檢測
- PCBA內(nèi)層燒毀失效分析深度解析 - 華南檢測案例分享
- 電子元器件檢測全攻略:權威機構一站式解決方案
- PCBA爆板失效分析:權威方法、技術揭秘與根本原因溯源
- LED失效分析:產(chǎn)品玻璃蓋板頻現(xiàn)碎裂
- PCB/PCBA切片分析:如何鎖定電子產(chǎn)品質量命門?
- 濾波器的“心臟驟停”:深挖共模電感短路背后的真相與解決方案
- 塑料外殼開裂失效分析:華南檢測揭秘材料失效的深層原因
- 陶瓷電容真假鑒別:為產(chǎn)品質量保駕護航
- 光耦失效分析案例分享:如何精準定位工藝“暗傷”?
- IC芯片漏電失效分析全揭秘:金屬污染是元兇?丨華南檢測
- 揭秘芯片開封(Decap):專業(yè)流程與步驟詳解,助力產(chǎn)品精準失效分析
- 驚心案例!華南檢測專家揭秘假冒電容器鑒別全過程,為企業(yè)避坑






