電子元器件失效分析案例深度解讀:MOS管柵氧擊穿的原因與預(yù)防
電子元器件失效分析案例深度解讀:MOS管柵氧擊穿的原因與預(yù)防
在電子設(shè)備可靠性領(lǐng)域,元器件失效分析是定位問題、提升品質(zhì)的關(guān)鍵環(huán)節(jié)。其中,MOS管失效分析因其結(jié)構(gòu)的特殊性而成為常見且重要的課題。本文將通過一個(gè)由專業(yè)失效分析檢測(cè)機(jī)構(gòu)執(zhí)行的完整案例,深度剖析MOS管柵氧擊穿失效分析的標(biāo)準(zhǔn)流程、根本原因及解決方案,為廣大工程師和質(zhì)量控制人員提供寶貴參考。

一、 MOS管失效背景與分析流程概覽
本次電子元器件失效分析的對(duì)象是2PCS MOS管,其中1PC為良品(OK品),1PC為不良品(NG品)。失效現(xiàn)象為NG品無法實(shí)現(xiàn)信號(hào)翻轉(zhuǎn),且阻值讀數(shù)異常。為定位根本原因,廣東省華南檢測(cè)技術(shù)有限公司啟動(dòng)了一套完整的分析流程,旨在通過層層遞進(jìn)的檢測(cè),精準(zhǔn)定位MOS管柵氧擊穿失效分析的核心問題。標(biāo)準(zhǔn)的分析流程包括:外觀檢查、電特性測(cè)試、X-RAY測(cè)試、破壞性分析以及SEM&EDS測(cè)試。

二、 MOS管失效詳細(xì)分析與核心發(fā)現(xiàn)
1. 外觀檢查:排除外部物理損傷
首先在光學(xué)顯微鏡下對(duì)樣品進(jìn)行觀察。結(jié)果顯示,OK品與NG品在銅線位置均存在焊珠顆粒,但此現(xiàn)象為共性,并非導(dǎo)致本次NG品功能異常的直接原因。這初步表明,問題可能隱藏在器件內(nèi)部,需要進(jìn)行更深入的元器件失效分析。

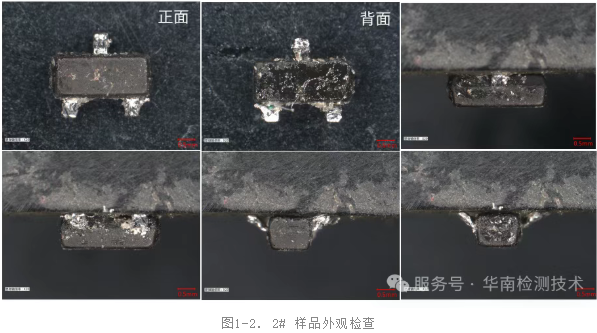
2. 電特性測(cè)試:捕捉典型失效癥狀
電特性測(cè)試是MOS管失效分析中定位問題的關(guān)鍵。我們首先使用萬用表進(jìn)行測(cè)量,發(fā)現(xiàn)NG品在特定腳位間的阻值(如16.3kΩ)遠(yuǎn)高于OK品(6.63kΩ)。隨后,在DS腳位施加5V電壓進(jìn)行動(dòng)態(tài)測(cè)試,NG品的阻值(7.14kΩ)同樣異常偏高。

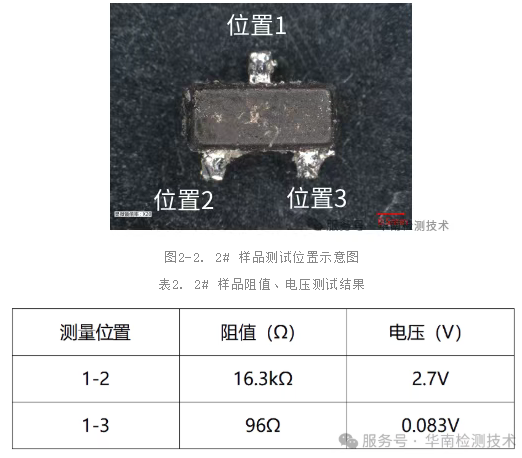
這揭示了什么?
這種阻值異常升高的現(xiàn)象,本質(zhì)上是源漏極之間漏電流急劇增大的直接體現(xiàn)。這正是柵氧層擊穿的典型電學(xué)特征,為后續(xù)的MOS管柵氧擊穿失效分析提供了明確的方向。

3. X-RAY與破壞性分析:聚焦芯片本體
為了探查內(nèi)部,我們進(jìn)行了X-RAY分析,結(jié)果顯示OK品與NG品均未發(fā)現(xiàn)焊線異常,這排除了封裝互聯(lián)問題。隨后進(jìn)行的開封破壞性分析,在顯微鏡下也未見芯片表面有明顯的物理損傷。

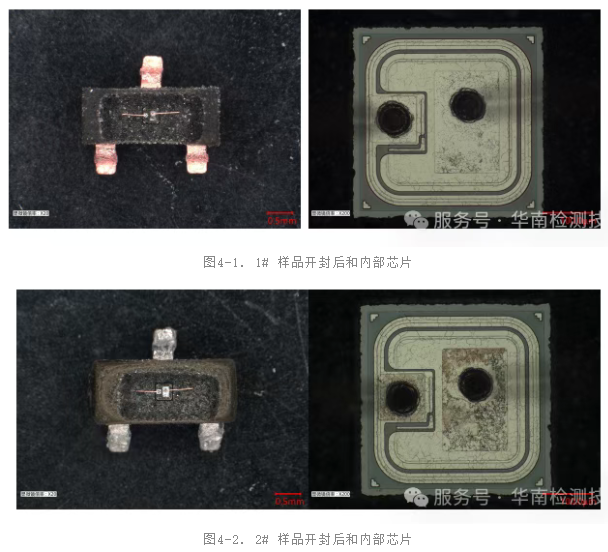
這些測(cè)試的意義何在?
X-RAY的作用在于無損觀察內(nèi)部結(jié)構(gòu),排除封裝隱患。而破壞性分析則讓我們能直接審視芯片核心。這兩步將故障點(diǎn)精準(zhǔn)地聚焦于芯片內(nèi)部的微觀結(jié)構(gòu),指引我們走向最終的材料成分分析。
4. SEM&EDS測(cè)試:鎖定根本原因的證據(jù)
掃描電鏡與能譜分析是本次電子元器件失效分析的決定性環(huán)節(jié)。對(duì)焊點(diǎn)進(jìn)行EDS元素分析后發(fā)現(xiàn),NG品右側(cè)焊點(diǎn)的某些檢測(cè)點(diǎn)位出現(xiàn)了異常高的氧元素含量(高達(dá)46.44%),并伴有硫、氯等污染元素。而OK品的成分則相對(duì)純凈。
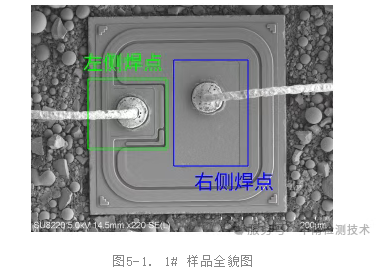
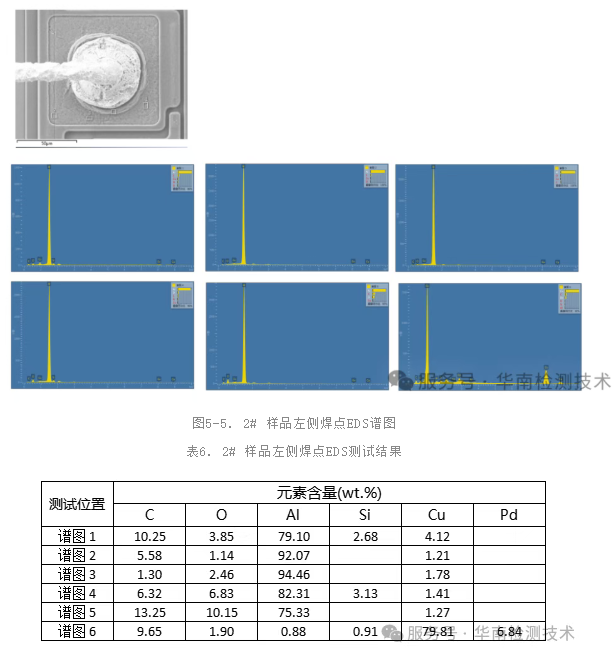
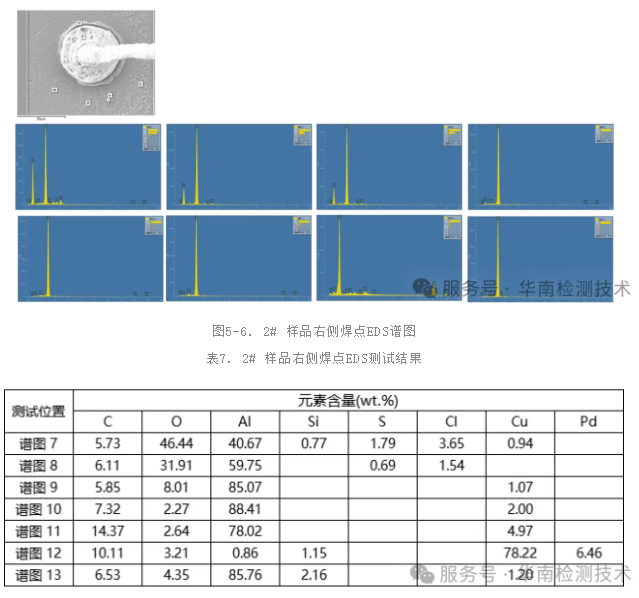
這些污染物如何導(dǎo)致失效?
這些污染物和異常氧化現(xiàn)象會(huì)顯著降低柵氧層的絕緣強(qiáng)度與可靠性。在電場(chǎng)作用下,它們成為導(dǎo)電路徑的薄弱點(diǎn),誘發(fā)柵氧擊穿。這一發(fā)現(xiàn)為本次MOS管柵氧擊穿失效分析提供了直接的微觀證據(jù)。
三、 綜合分析結(jié)論與行業(yè)建議
通過以上系統(tǒng)的元器件失效分析,我們確認(rèn):NG品MOS管因制造過程中可能引入了污染物或受到靜電損傷,導(dǎo)致柵氧層完整性被破壞。在通電工作時(shí),源漏極之間產(chǎn)生大漏電流,導(dǎo)致柵氧層擊穿,造成MOS管功能失效。
基于這一結(jié)論,我們?yōu)闃I(yè)界提出兩大核心建議,以預(yù)防此類MOS管失效分析中常見的問題:
加強(qiáng)生產(chǎn)制程靜電管控:必須從源頭上杜絕ESD對(duì)敏感柵極的潛在損傷,這是預(yù)防柵氧擊穿最有效的措施之一。
優(yōu)化MOS管保護(hù)電路:在電路設(shè)計(jì)端,應(yīng)增加適當(dāng)?shù)木彌_電路或穩(wěn)壓器件,以抑制工作中可能出現(xiàn)的浪涌電壓和過壓應(yīng)力,為器件提供可靠的保護(hù)屏障。
華南檢測(cè):http://m.lysyyey.com/websiteMap
四、 結(jié)語
本次完整的MOS管柵氧擊穿失效分析案例,廣東省華南檢測(cè)技術(shù)有限公司系統(tǒng)地展示了一家專業(yè)失效分析檢測(cè)機(jī)構(gòu)如何通過多技術(shù)聯(lián)用,從電氣異常現(xiàn)象追溯到微觀材料成分的根本原因。深入的電子元器件失效分析不僅是一個(gè)解決問題的過程,更是持續(xù)改進(jìn)產(chǎn)品可靠性、指引設(shè)計(jì)和生產(chǎn)方向的重要活動(dòng)。對(duì)于高可靠性要求的領(lǐng)域,重視并善用專業(yè)的元器件失效分析服務(wù),是保障產(chǎn)品長(zhǎng)期穩(wěn)定運(yùn)行不可或缺的一環(huán)。

猜你感興趣的文章:
PCBA內(nèi)層燒毀失效分析深度解析 - 華南檢測(cè)案例分享
電子元器件檢測(cè)全攻略:權(quán)威機(jī)構(gòu)一站式解決方案
塑膠失效分析:深度剖析塑膠螺絲柱開裂失效分析的全過程與解決方案
塑料失效分析:外殼開裂的根本原因診斷與案例深度解析 | 華南檢測(cè)
PCBA爆板失效分析:權(quán)威方法、技術(shù)揭秘與根本原因溯源
熱門資訊 
最新資訊 
- ?PCBA失效分析實(shí)驗(yàn)室:如何用高端檢測(cè)設(shè)備,精準(zhǔn)診斷“不明原因”批量故障
- PCB失效分析檢測(cè)機(jī)構(gòu) - 廣東省華南檢測(cè)CNAS實(shí)驗(yàn)室
- 芯片焊點(diǎn)失效分析“破案”實(shí)錄:一文看懂如何根治焊接隱患
- 元器件失效分析全解讀:定位根因,終結(jié)批量性質(zhì)量危機(jī)
- 電子元器件失效分析案例深度解讀:MOS管柵氧擊穿的原因與預(yù)防
- 元器件篩選權(quán)威解讀:為何第三方檢測(cè)是保障產(chǎn)品可靠性關(guān)鍵一環(huán)?
- 塑膠失效分析:深度剖析塑膠螺絲柱開裂失效分析的全過程與解決方案
- 塑料失效分析:外殼開裂的根本原因診斷與案例深度解析 | 華南檢測(cè)
- PCBA內(nèi)層燒毀失效分析深度解析 - 華南檢測(cè)案例分享
- 電子元器件檢測(cè)全攻略:權(quán)威機(jī)構(gòu)一站式解決方案
- PCBA爆板失效分析:權(quán)威方法、技術(shù)揭秘與根本原因溯源
- LED失效分析:產(chǎn)品玻璃蓋板頻現(xiàn)碎裂
- PCB/PCBA切片分析:如何鎖定電子產(chǎn)品質(zhì)量命門?
- 濾波器的“心臟驟停”:深挖共模電感短路背后的真相與解決方案
- 塑料外殼開裂失效分析:華南檢測(cè)揭秘材料失效的深層原因
- 陶瓷電容真假鑒別:為產(chǎn)品質(zhì)量保駕護(hù)航
- 光耦失效分析案例分享:如何精準(zhǔn)定位工藝“暗傷”?
- IC芯片漏電失效分析全揭秘:金屬污染是元兇?丨華南檢測(cè)
- 揭秘芯片開封(Decap):專業(yè)流程與步驟詳解,助力產(chǎn)品精準(zhǔn)失效分析
- 驚心案例!華南檢測(cè)專家揭秘假冒電容器鑒別全過程,為企業(yè)避坑






